
掃碼添加微信�,獲取更多半導(dǎo)體相關(guān)資料
摘要
? ? ? 本文主要研究隨機(jī)印刷故障,如空間中的微橋或隨機(jī)缺失觸點(diǎn)���。本文用一個(gè)稱之為NOK(不確定)的度量來量化這種故障�,這個(gè)度量本質(zhì)上代表了故障概率�����。本文使用一個(gè)名為Stochalis的內(nèi)部軟件包,通過掃描電鏡圖像分析來測(cè)量這個(gè)NOK量�。本文將論證這種失效概率的最基本的依賴性是它的CD依賴性:NOK(CD)。使用目前可用的光盤掃描電鏡或電子束檢測(cè)工具�,現(xiàn)在可以將這種氮氧化物(光盤)依賴性測(cè)量到ppm-ppb水平。這不足以證明或否定產(chǎn)量�����,但NOK(CD)函數(shù)是比較材料和條件的極好工具���,即����。量化對(duì)圖案化條件的敏感性并顯示改進(jìn)方向��。本文將舉例說明劑量�、間距��、抗蝕劑���、蝕刻和照明模式的影響����。本文還將展示從非常局部到全局的光盤非均勻性如何進(jìn)一步影響局部故障概率。最后���,本文將討論隨機(jī)故障概率和光盤非均勻性一起�����,在光盤和音高上設(shè)置實(shí)際分辨率限制�。這些限制不是絕對(duì)的��,因?yàn)樗鼈內(nèi)Q于圖案設(shè)置和使用的材料���,但是在設(shè)置EUVL工藝時(shí)���,需要非常仔細(xì)地考慮它們。
?
介紹
? ? ? 巖性1中的術(shù)語(yǔ)“隨機(jī)效應(yīng)”是指發(fā)生在原則上應(yīng)完全相同的結(jié)構(gòu)之間的隨機(jī)局部變化����。“傳統(tǒng)的”LWR和LCDU指標(biāo)量化了由此產(chǎn)生的局部CD可變性�。但比局部光盤可變性嚴(yán)重得多的是局部印刷故障,例如空間中的微橋或觸點(diǎn)缺失��,因?yàn)樗鼈冎苯佑绊懏a(chǎn)量。當(dāng)圖案尺寸變得非常小時(shí)���,這種隨機(jī)印刷故障開始發(fā)生�。隨著EUV的引入���,目標(biāo)尺寸大幅躍升至更小的值����,這意味著隨機(jī)故障現(xiàn)在更接近甚至出現(xiàn)在臨界尺寸目標(biāo)和標(biāo)稱條件下�。因此,對(duì)隨機(jī)故障的研究���,即它們開始出現(xiàn)的時(shí)間����,它們依賴于什么�����,以及如何將其最小化���,就成為一個(gè)非常重要的問題��。這是本文的主題�。
? ? ? 在本文中�,本文將首先簡(jiǎn)要地提醒本文已經(jīng)介紹的用于量化隨機(jī)故障的度量,一種稱為——諾克(不正常)���。
?
諾克(光盤):依賴關(guān)系
? ? ? 長(zhǎng)期以來�����,人們已經(jīng)知道并理解了暴露劑量對(duì)EUV隨機(jī)理論的影響�����,因此本文描述了一個(gè)實(shí)驗(yàn)�,本文做這個(gè)實(shí)驗(yàn)是為了量化劑量大小對(duì)LWR的影響���,通過選擇固定的掩模結(jié)構(gòu)��,并將其暴露于相同的晶片CD�,對(duì)每種抗蝕劑使用適當(dāng)?shù)膭┝?���,我們有效地生成了恒定CD下的pixNOK(劑量-尺寸)曲線���。正如所預(yù)期的,隨機(jī)失效概率非常強(qiáng)烈地依賴于劑量�����。當(dāng)劑量從~25 mJ/cm2增加到~70 mJ/cm2時(shí)���,pixNOK下降3個(gè)數(shù)量級(jí)以上.這非常清楚地表明�����,劑量是對(duì)抗隨機(jī)故障的非常強(qiáng)的武器��,在設(shè)置任何關(guān)鍵的EUV應(yīng)用時(shí)都應(yīng)該仔細(xì)考慮��,即使較高的劑量不可避免地也會(huì)導(dǎo)致較低的吞吐量�����。因此����,在吞吐量和現(xiàn)場(chǎng)之間找到正確的平衡是每個(gè)應(yīng)用程序需要解決的重要問題之一���。?
? ? ? 當(dāng)然��,除了劑量-大小之外�,抗蝕劑還有許多影響其隨機(jī)失效性能的特性�����。
? ? ? 還有一個(gè)重要的問題是�����,在蝕刻過程中����,在石層面觀察到的隨機(jī)故障如何轉(zhuǎn)移(或不轉(zhuǎn)移)預(yù)期至少一些故障(例如非常窄的微橋)不能在蝕刻過程中“存活”。
?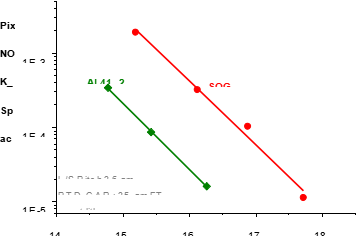
圖8 底層特性對(duì)微橋數(shù)量影響的示例���。(間距36納米�����,PTD-卡爾�����,劑量約30兆焦耳/平方厘米���,光刻后����,類星體照明)
?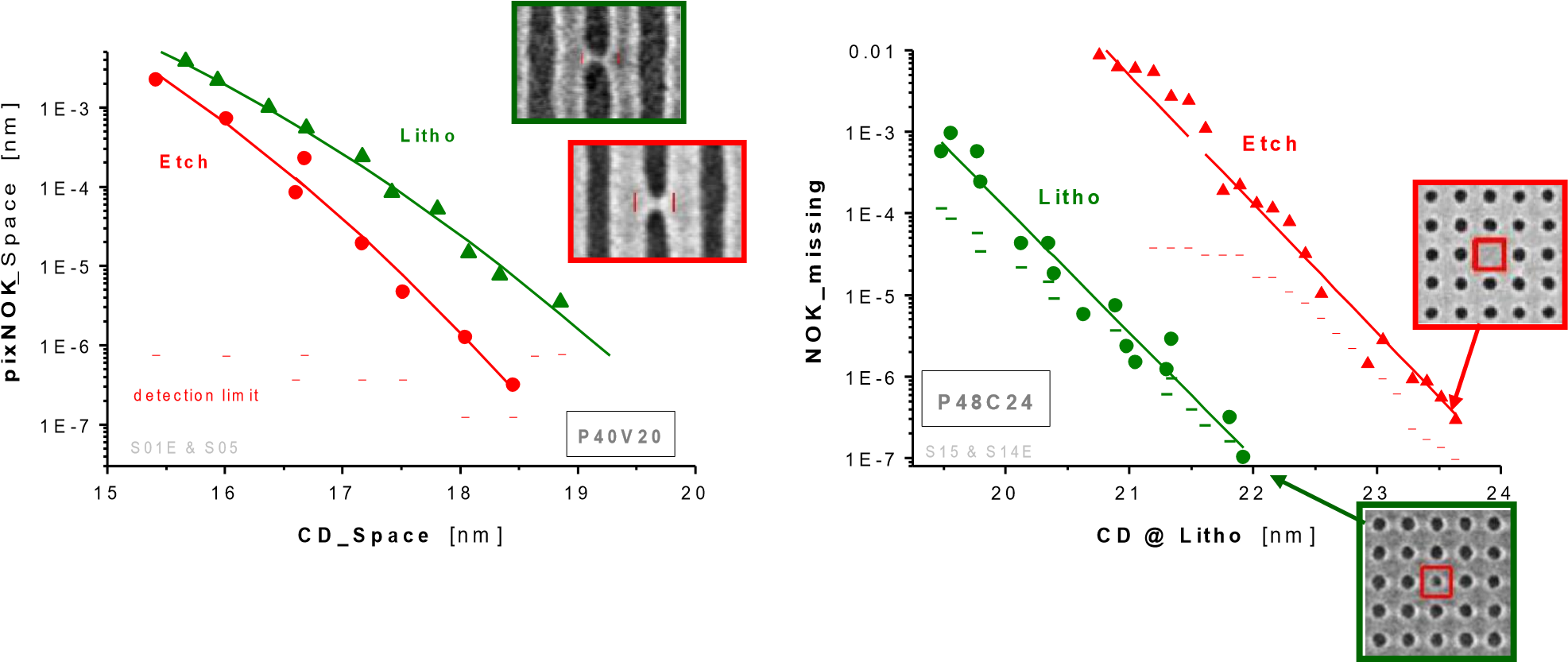
圖9 蝕刻前后的氮氧化物(鎘)測(cè)量的兩個(gè)例子�����。橫軸表示印后光盤�,因此需要比較“垂直方向”上的點(diǎn)。這些例子表明�����,蝕刻可以改善隨機(jī)故障計(jì)數(shù)以及制造
?
光盤不均勻性的影響 ?略
?
總結(jié)
? ? ? ?本文中的數(shù)據(jù)�����,以及我們之前的工作和許多其他人的工作都向我們展示了這一點(diǎn)��,隨機(jī)印刷故障是現(xiàn)實(shí)�����,并已成為EUV石印15的主要問題。隨機(jī)故障一直存在�����,但它們過去主要發(fā)生在遠(yuǎn)離標(biāo)稱運(yùn)行條件的地方���。因此,隨機(jī)印刷故障會(huì)對(duì)產(chǎn)量產(chǎn)生很大影響���,并因此對(duì)最小產(chǎn)量光盤和產(chǎn)量間距設(shè)定了新的實(shí)際限制�。根據(jù)我們自己的研究結(jié)果���,并利用當(dāng)前的EUV工具和材料��,我們估計(jì)實(shí)際的間距分辨率極限對(duì)于L/S結(jié)構(gòu)在32-36 nm范圍內(nèi)�����,對(duì)于觸點(diǎn)在36-40 nm間距范圍內(nèi)���。幸運(yùn)的是,隨機(jī)故障可以通過基于掃描電鏡的工具、光盤掃描電鏡或EBI型工具來檢測(cè)���,使用“車載”或離線軟件來檢查圖像����。(對(duì)于光盤掃描電子顯微鏡圖像����,后期平版印刷或后期蝕刻,我們使用我們自己的內(nèi)部軟件包�,稱為Stochalis。
? ? ? 同樣清楚的是���,圖案化過程的許多實(shí)驗(yàn)設(shè)置影響隨機(jī)失效概率�����,這意味著可以從多個(gè)角度尋求改進(jìn)��。最值得注意的是����,對(duì)于給定的目標(biāo)CD�,劑量大小(或者更確切地說��,吸收的光子密度)具有非常強(qiáng)的影響��。目標(biāo)CD本身和音高的值也是如此�����。但是許多其他因素也影響失敗概率�����,例如抗蝕劑、底層���、掩模和工藝均勻性���、照明模式、蝕刻����,以及可能的其他因素。也就是說��,如果要獲得產(chǎn)量�,顯然必須進(jìn)行這種隨機(jī)性能優(yōu)化:隨機(jī)失效性能的量化和優(yōu)化必須成為任何關(guān)鍵圖案模塊開發(fā)周期的標(biāo)準(zhǔn)部分�。
?
文章全部詳情��,請(qǐng)加華林科納V了解:壹叁叁伍捌零陸肆叁叁叁
?