
掃碼添加微信����,獲取更多半導(dǎo)體相關(guān)資料
摘要
? ? ? 在鋸切階段后的自動(dòng)檢測(cè)(AOI)過(guò)程中,觀察到成品率大幅下降��。進(jìn)行一步一步的AOI檢驗(yàn)檢查和缺陷審查�����,以查看哪一步導(dǎo)致了大的產(chǎn)量下降�����,哪種缺陷對(duì)產(chǎn)量下降的貢獻(xiàn)最大。掃描電鏡和能譜分析顯示了顆粒的形狀和化學(xué)元素��。從EDS的結(jié)果來(lái)看�,粒子可以分為兩類(lèi)。一種是無(wú)機(jī)相關(guān)材料�����,主要包括硅元素��,來(lái)自saw階段��。通過(guò)實(shí)驗(yàn)設(shè)計(jì)��,找到合理的聲表面波相關(guān)參數(shù)���,并對(duì)其進(jìn)行優(yōu)化,以去除聲表面波級(jí)中的粒子���。但是這種粒子的數(shù)量很少��。產(chǎn)量只提高了不到5%�����。我們的主要努力是去除另一種顆粒����,即有機(jī)相關(guān)材料,主要包括碳和氧元素����。這種顆粒來(lái)自膠帶殘留物。為了去除殘留的膠帶�����,在鋸臺(tái)之前增加了一個(gè)步驟�。幾乎所有殘留的膠帶都被移除了,最終產(chǎn)率提高了15%以上��。
?
介紹
? ? ? 在本文中�,AOI步驟的產(chǎn)量下降大部分是由粒子造成的。電子封裝組件中的顆粒一直是一項(xiàng)非常具有挑戰(zhàn)性的去除工作����。一些顆粒會(huì)直接導(dǎo)致質(zhì)量問(wèn)題,而另一些顆?���?赡軙?huì)引發(fā)可靠性問(wèn)題。找到粒子的根本原因,識(shí)別它����,描述它是如何發(fā)生的,然后消除它���,這是非常重要的�����。同時(shí),粒子可能來(lái)自各種來(lái)源�,如直接物質(zhì)、間接物質(zhì)����、環(huán)境、設(shè)備�,甚至人類(lèi)。在過(guò)去��,大量的研究已經(jīng)調(diào)查了缺陷形成�。本文提出了一種新的方法來(lái)除去幾乎所有的這些顆粒,最終產(chǎn)率提高了15%以上����。
?
粒子軌跡
? ? ? 為了避免資源浪費(fèi)��,請(qǐng)執(zhí)行兩個(gè)步驟分別在引入和探測(cè)步驟后添加�。在進(jìn)入步驟之后�,在鋸床中使用清潔功能,然后在所有晶片上運(yùn)行AOI���。平均收率為85.7%�。審查結(jié)果顯示��,幾乎所有的缺陷都是晶圓廠問(wèn)題����,包括表面劃痕、金屬缺失����、焊盤(pán)腐蝕和小顆粒。然后用AOI檢驗(yàn)步驟探測(cè)和操作所有10個(gè)晶片�。平均收率為83.4%。復(fù)查結(jié)果顯示����,附加缺陷是一個(gè)顆粒�����,應(yīng)該來(lái)自探針機(jī)��。晶片在潔凈室被探測(cè)���,潔凈室是10K級(jí)的,環(huán)境中應(yīng)該有一些微粒��。因此�,產(chǎn)量下降是正常的,可以通過(guò)鋸清潔步驟消除�����。鋸清潔功能用于清潔所有晶圓��,然后AOI再次進(jìn)行����。收益率回到了85%的水平��。然后所有的晶圓被鋸����,AOI再次檢查�����。產(chǎn)量下降了大約15%?,F(xiàn)在收益率在70%的水平�����。鋸切步驟包含清潔步驟���,這意味著清潔功能無(wú)法消除15%的產(chǎn)量下降�����。在回顧了所有的缺陷之后��,我們發(fā)現(xiàn)幾乎所有的附加缺陷都是粒子�。從這個(gè)實(shí)驗(yàn)中�����,我們知道大的產(chǎn)量下降是由鋸步引起的����,產(chǎn)量下降的原因是顆粒����。
?
?粒子分析 ?
? ? ? ? 圖3顯示了無(wú)機(jī)相關(guān)材料��,主要包括一種Si元素���。缺陷尺寸約為40米�����。圖����。圖4顯示了有機(jī)相關(guān)材料���,主要包括一種碳和氧元素。這個(gè)缺陷的尺寸約為8米�����。他們倆都是從鋸子臺(tái)來(lái)的��。對(duì)于硅顆粒來(lái)說(shuō),它是saw過(guò)程中的硅殘余物����,太大而不能被清潔系統(tǒng)去除。為了解決這種顆粒�����,應(yīng)優(yōu)化鋸切或清潔參數(shù)���。對(duì)于碳和氧粒子�����,它來(lái)自膠帶殘留物�,因?yàn)橹挥心z帶材料具有有機(jī)相關(guān)材料�。由于膠帶在紫外線階段之前非常粘,如果膠帶殘留物粘附在芯片表面�����,很難去除��。
顆粒去除和產(chǎn)量提高
? ? ? 從上面的分析來(lái)看���,兩種粒子的產(chǎn)量下降很大���。由于這兩種粒子的性質(zhì)不同����,我們分別進(jìn)行了解析�。無(wú)機(jī)粒子主要是殘留的硅。它們可以通過(guò)調(diào)整聲表面波參數(shù)以產(chǎn)生越來(lái)越少的顆粒來(lái)解決����,并且可以通過(guò)調(diào)整清潔參數(shù)來(lái)去除。因此���,使用兩個(gè)DOE通過(guò)調(diào)整鋸和清潔參數(shù)來(lái)監(jiān)控產(chǎn)量下降性能���。見(jiàn)表1.在該表中,我們更改了不同的參數(shù)��,以找到saw工藝的優(yōu)化參數(shù)��。
? ? ? 見(jiàn)表4中的結(jié)果.表面紫外線照射后�,膠帶殘留物的粘性比以前小���。膠帶的殘留物也不粘��,很容易通過(guò)清潔步驟去除�����。清洗后��,我們?cè)俅芜\(yùn)行AOI檢查���,發(fā)現(xiàn)產(chǎn)量回到了85%的水平����。選擇兩張晶片圖作為樣本��。參見(jiàn)圖�����。圖5和圖6���。6顯示了工藝優(yōu)化前后更差和更好的產(chǎn)率圖����。然后又使用了20個(gè)工程晶片為了驗(yàn)證它。結(jié)果是相似的���,剩余的10%產(chǎn)量損失被回收���。所有的缺陷都是在顯微鏡下檢查的,幾乎所有的缺陷都是晶圓廠的問(wèn)題��,就像晶圓是在AOI檢查之后檢查的一樣��。所有工程晶片的當(dāng)前產(chǎn)量與引入的AOI產(chǎn)量相似�����,并且在管芯表面上幾乎沒(méi)有顆粒和附加缺陷�����。該方法對(duì)提高產(chǎn)量非常有效��。雖然它會(huì)增加一些周期時(shí)間�,但它給了我們更多的利潤(rùn)。
?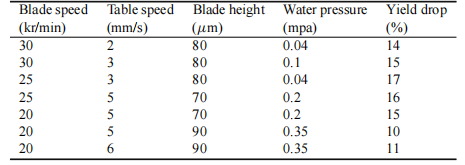
表1 能源部尋找優(yōu)化鋸鋸參數(shù)
 ?
?
表4 具有不同速度的頂部側(cè)面的紫外線
 ?
?
圖5工藝優(yōu)化前的葉片產(chǎn)率(75.52%)
結(jié)論
? ? ? 缺陷檢查和審查表明�����,顆粒是對(duì)我們的產(chǎn)量缺陷最常見(jiàn)的影響�。能譜分析表明有兩種顆粒。一個(gè)是硅殘留物��,另一個(gè)是膠帶殘留物�。我們調(diào)整了saw參數(shù)以去除硅殘留物,并使用了額外的表面紫外線步驟來(lái)去除膠帶殘留物�����。最后�,我們?cè)谏a(chǎn)中實(shí)施了這兩項(xiàng)變革,并使產(chǎn)量提高了約15%��。我們還有其他產(chǎn)量損失問(wèn)題需要解決����,但它們都是晶圓廠問(wèn)題缺陷。我們將與晶圓廠一起致力于產(chǎn)量的提高�,下次將分享一些經(jīng)驗(yàn)。
?
文章全部詳情�,請(qǐng)加華林科納V了解:壹叁叁伍捌零陸肆叁叁叁
?