
掃碼添加微信,獲取更多半導(dǎo)體相關(guān)資料
摘要
? ? ? 硅基于酸的濕法蝕刻中的傳輸和動力學(xué)效應(yīng)的研究已經(jīng)完成����。由反應(yīng)形成的氣泡附著在表面上的隨機(jī)位置���,表面的一部分被反應(yīng)物遮蔽�����。這種氣泡掩蔽效應(yīng)被模擬為與液相傳質(zhì)阻力平行作用的氣泡傳輸阻力���。這些輸運(yùn)效應(yīng)被集中成一個(gè)有效的質(zhì)量輸運(yùn)電阻�����,它與動力學(xué)電阻串聯(lián)作用����。結(jié)果表明����,刻蝕表面形貌是有效傳質(zhì)阻力與動力學(xué)阻力之比的函數(shù)�����。粗糙的表面是由峰和谷組成的區(qū)域。理論上�����,在質(zhì)量傳遞影響下����,峰值處的蝕刻速率高于谷值處的蝕刻速率。因此���,表面被化學(xué)拋光�。結(jié)果表明,拋光效率隨著傳質(zhì)阻力與動力學(xué)阻力之比的增大而增大�,達(dá)到最大值后減小。用發(fā)展的唯象模型和實(shí)驗(yàn)數(shù)據(jù)解釋了傳質(zhì)和動力學(xué)對表面粗糙度和光澤度的影響�。
?
介紹
? ? ? 硅晶片的化學(xué)蝕刻是通過將晶片浸入蝕刻劑中來完成的,該蝕刻劑傳統(tǒng)上是硝酸和氫氧化鉀的稀釋劑或苛性堿溶液的酸性混合物�。報(bào)道了苛性結(jié)晶學(xué)蝕刻的各種研究.2-4然而��,本文只關(guān)注基于酸的蝕刻的傳輸和動力學(xué)效應(yīng)�。實(shí)際的反應(yīng)機(jī)理相當(dāng)復(fù)雜,涉及許多基本反應(yīng)��。氫和不同的氮氧化物會產(chǎn)生�。已經(jīng)提出了許多不同條件下硅片溶解的速率方程�。
? ? ? 本研究的目的是展示我們的實(shí)驗(yàn)數(shù)據(jù),并使用一種新的非均相反應(yīng)現(xiàn)象學(xué)模型對其進(jìn)行分析��。我們收集的數(shù)據(jù)與提出的非均相反應(yīng)唯象模型一致����,可以解釋硅表面特性的各個(gè)方面��。由于提出的模型解釋了早期研究沒有解釋的蝕刻硅晶片表面的不同特征����,因此有必要在公開文獻(xiàn)中報(bào)告這些數(shù)據(jù)和分析�����。
?
實(shí)驗(yàn)
? ? ? 實(shí)驗(yàn)在兩種不同的裝置中進(jìn)行���。大多數(shù)實(shí)驗(yàn)都是使用圖1所示的裝置進(jìn)行的。7a蝕刻劑酸與任選的高壓氮?dú)庖黄鸨凰腿胛g刻機(jī)�。當(dāng)任選引入氮?dú)鈺r(shí),其在液體中保持良好的混合�,并且部分以氣泡的形式存在���。包含硅晶片的處理盒被放置在蝕刻機(jī)中�����,如圖所示����。7a . 處理箱內(nèi)裝有一組轉(zhuǎn)子����,可使晶圓圍繞其中心旋轉(zhuǎn)�。在不同的濃度和溫度下蝕刻硅片,并使用三相唯象模型分析收集的數(shù)據(jù)�。
?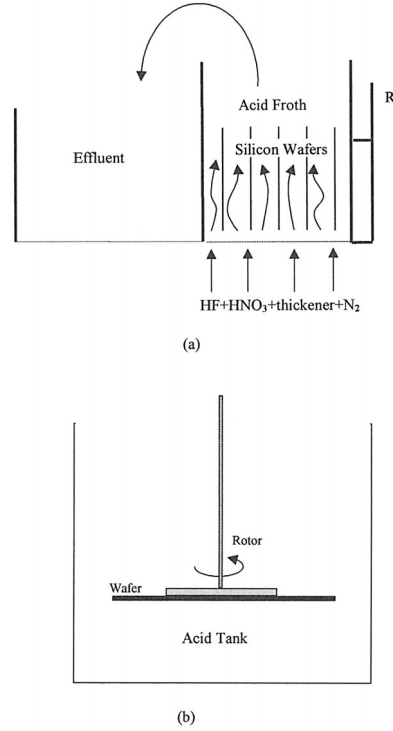
圖7 (a)蝕刻硅晶片的實(shí)驗(yàn)組件 (b)不同轉(zhuǎn)速下單晶圓蝕刻的實(shí)驗(yàn)裝置
結(jié)果和討論
? ? ? 光滑拋光硅片的表面輪廓如圖所示9a從圖中可以看出,在設(shè)備的分辨率范圍內(nèi)沒有檢測到表面不規(guī)則�。LSP(圖。9b)的拋光晶片沒有顯示出表面不規(guī)則�。然后在HF 1 HNO3 1H3PO4的混合物中以5轉(zhuǎn)/分的速度蝕刻這些拋光的晶片.蝕刻晶片的表面輪廓和最小二乘法如圖所示�。10a和b。顯然�,表面不規(guī)則是由表面上形成的氣泡引起的。由于晶片轉(zhuǎn)速非?���?梢酝ㄟ^以較低的Rm、eff��、I蝕刻晶片來實(shí)現(xiàn)�。傳質(zhì)阻力隨著混合強(qiáng)度或表面剪切的增加而減小���。表面剪切以及混合強(qiáng)度通過增加晶片旋轉(zhuǎn)速度而增加。因此����,在相同的酸混合物中以60轉(zhuǎn)/分的速度蝕刻硅晶片�,該實(shí)驗(yàn)的結(jié)果顯示在圖1中。11a和b�。
? ? ? 圖14顯示了外在氣泡對表面粗糙度的影響����。在1.5 M HF +1.5 M H3PO4 過量硝酸混合物中���,在有和沒有外來氮?dú)夤呐莸那闆r下��,蝕刻具有非常低光澤度(0-5光澤度單位)和高f (0.2-0.3 mm)的粗糙硅晶片��。當(dāng)存在固有的氣泡掩蔽效應(yīng)時(shí)��,粗糙度的改善非常差��,即,��。當(dāng)Rm���、g較高時(shí)。當(dāng)存在外來氣泡時(shí)����,Rm,g較低�����,因此,在存在外來氣泡時(shí)����,拋光效率和粗糙度的降低較高���。因此,在不同流體動力學(xué)條件下蝕刻的硅晶片的粗糙度可以用所提出的唯象模型來解釋�。
? ? ? 蝕刻劑溫度��,如氟化氫的濃度��,會影響動態(tài)電阻��。它也會影響傳質(zhì)阻力��。因此���,Rr�、HF和Rm�����、eff����、HF都隨著溫度的升高而降低��。對于對溫度依賴性較弱的反應(yīng),動力學(xué)效應(yīng)隨溫度增加���。對于對溫度有強(qiáng)烈依賴性的反應(yīng),傳質(zhì)效應(yīng)隨著溫度的升高而增加�����。然而��,在不同的蝕刻條件下����,這些參數(shù)對溫度的依賴性可能不同。為研究溫度的影響而進(jìn)行的一些實(shí)驗(yàn)產(chǎn)生了不清楚的結(jié)果�����。
?
圖14 外部冒泡對粗糙度的影響
結(jié)論
? ? ? 硅蝕刻法是一種受傳質(zhì)影響的三相體系���。三相蝕刻系統(tǒng)可以在現(xiàn)象學(xué)上建模為一個(gè)兩相系統(tǒng)。傳質(zhì)和動力學(xué)對蝕刻過程的動力學(xué)影響可以用有效的擴(kuò)散電阻與動力學(xué)電阻的比值來解釋�����。一個(gè)粗糙的硅片是一個(gè)以平均粗糙度為特征的峰谷場�。在傳質(zhì)影響系統(tǒng)中����,由于局部傳質(zhì)電阻的不同����,峰處的蝕刻速率高于谷處的蝕刻速率����。因此���,在存在傳質(zhì)的情況下發(fā)生化學(xué)拋光�。利用所提出的現(xiàn)象學(xué)模型和實(shí)驗(yàn)數(shù)據(jù)解釋了拋光效率(實(shí)際拋光速率與最大拋光速率的比)與有效傳質(zhì)阻力與動力學(xué)阻比的關(guān)系。
? ? ? 蝕刻反應(yīng)的氣體產(chǎn)物形成固有的泡沫�,掩蓋了硅晶圓表面的局部位置,這導(dǎo)致表面不規(guī)則�,這可以用氣泡掩蓋缺陷來解釋�����。氣泡脫離表面的影響���,以及氣泡和高頻通過傳質(zhì)膜的傳輸被歸類為一個(gè)有效的傳質(zhì)電阻。在沒有過多的泡沫掩蔽效應(yīng)的情況下����,拋光效率隨著有效傳質(zhì)電阻與動力學(xué)電阻之比而提高��,達(dá)到最佳值�����,然后減小��。當(dāng)這個(gè)比率大于臨界氣泡掩蔽阻值時(shí)���,氣泡掩模拋光效率顯著,因此拋光效率降低�����。拋光效率的降低也可以導(dǎo)致在非常高的傳質(zhì)電阻的峰和谷蝕刻速率之間的差異的減少���。添加增稠劑增加傳質(zhì)阻�����。因此���,通過加入惰性增稠劑��,可以增加傳質(zhì)阻與動力學(xué)阻的比值����。此外��,動力學(xué)電阻隨著高頻濃度的變化而變化,對傳質(zhì)電阻的影響可以忽略不計(jì)���。因此����,這個(gè)比率也可以通過改變心衰濃度來控制����。當(dāng)濺射電阻和動力學(xué)電阻隨溫度變化時(shí)�,拋光效率不隨溫度有明顯變化。
? ? ? 因此����,有效傳質(zhì)阻力與動力學(xué)阻的比值必須高于臨界最小值,并低于臨界氣泡掩蔽值����,才能達(dá)到較高的拋光效率
文章全部詳情��,請加華林科納V了解:壹叁叁伍捌零陸肆叁叁叁