
掃碼添加微信,獲取更多半導體相關資料
引言
? ? ? 近年來����,隨著集成電路的微細化�,半導體制造的清洗方式從被稱為“批量式”的25枚晶片一次清洗的方式逐漸改變?yōu)椤皢螐埵健钡木淮吻逑吹姆绞健T诎雽w的制造中��,各工序之間進行晶片的清洗��,清洗工序次數(shù)多�,其時間縮短、高精度化決定半導體的生產(chǎn)性和質(zhì)量�。在單張式清洗中����,用超純水沖洗晶片 ,一邊高速旋轉(zhuǎn),一邊從裝置上部使干燥的空氣流過���。在該方式中,逐個處理晶片�。上一行程粒子的交錯污染少。近年來����,由于高壓噴氣和極低溫的關于向粒子噴射氮氣溶膠等“清洗能力相關技術”進行了大量研究;另一方面�,關于通過清洗暫時遠離晶片的粒子����,重新附著到晶片上,進行葉片式清洗����,在干燥時晶片和保持晶片的轉(zhuǎn)盤高速旋轉(zhuǎn)����。
?
實驗
單張式清洗裝置模型:圖1a表示裝置整體的系統(tǒng)圖�����,圖1b表示測定部的詳細情況�����。測定部由模擬清洗機處理室的直徑D=520mm�����、高470mm的圓筒構成����,其中放置有半徑R=165mm的圓板���。另外,本研究還包括吹向圓板的氣流通過送風機在裝置內(nèi)循環(huán)��。送風機送來的氣流通過節(jié)流流量計�����,通過設置在處理室上方的流路��,流入長1830mm的助跑區(qū)間��。助跑區(qū)間入口設有格子間隔26mm的整流用蜂窩�����,在本研究中�����,硅片和保持硅片的卡盤工作臺簡化為一個���,將厚度10mm的鋁制圓板用作旋轉(zhuǎn)圓板�����,在該圓板下部設置有排氣罩���,在其內(nèi)側(cè)設置有3個排氣口另外,處理室的間隙分別為28mm�����、45mm����。流入測量部的氣流與旋轉(zhuǎn)圓板碰撞��,通過排氣罩和處理室的間隙(以下將其稱為排氣狹縫)進入排氣罩內(nèi)����,從排氣口返回送風機。
 ?
?
圖1 ?1a示出了實驗裝置的示意圖實驗裝置的示意圖����,箭頭表示流動回路及其方向���。圖1b顯示了轉(zhuǎn)盤附近的細節(jié)。該圖還顯示了粒子圖像測速的光學系統(tǒng)和測量區(qū)域
2PIV測量:測量中使用了PIV�����。PIV用示蹤劑使用了用加熱器加熱丙二醇水溶液并霧化后的煙霧���。在本文中�����,以調(diào)查從圓板產(chǎn)生的渦流到處理室內(nèi)壁的平流為目的��,用圖1b虛線表示�����。
LES計算:雖然本PIV測量是非穩(wěn)態(tài)測量���,但是只能掌握從圓板附近到管壁的二維流動的舉動�����。 實際的趨勢是,由于伴隨圓盤旋轉(zhuǎn)的8個方向的流動����,因此呈三維結(jié)構,本PIV是該三維結(jié)構的一部分 不過是按時間順序追趕著部�����。因此,在PIV測量的基礎上進行了三維數(shù)值計算����,通過實驗和計算的互補�,嘗試了更準確地推測現(xiàn)實中在清洗機內(nèi)形成的流動的三維結(jié)構�����。
?
結(jié)果和討論
基于1Q2值的渦流區(qū)域辨識中,著眼于在可能引起垃圾再次附著的清洗機內(nèi)形成的渦流結(jié)構��。因此�,根據(jù)PIV測量LES計算的兩個數(shù)據(jù)計算速度梯度張量的第2不變量,計算出以下定義的Q2值����,確定了轉(zhuǎn)彎勝過剪切的區(qū)域。
圖2c表示其結(jié)果��,圖為根據(jù)圖2b的瞬時速度場計算出的Q2值分布����,Q2 > 5000的順時針旋轉(zhuǎn)區(qū)域用藍色表示,逆時針旋轉(zhuǎn)區(qū)域用紅色表示�。根據(jù)圖可知,從流速快的圓板端到排氣狹縫的帶狀區(qū)域中存在多個漩渦���。 渦流層外緣側(cè)紅色表示的逆時針渦流很多,內(nèi)緣側(cè)藍色表示的順時針渦流很多��。另外�����,在圓板和排氣罩之間的區(qū)域����,速度矢量看起來不規(guī)則排列���,但值本身很小。根據(jù)該圖�,在圓板端生成預計形成的微小漩渦主要沿著平均流移動,被吸入排氣狹縫����。
?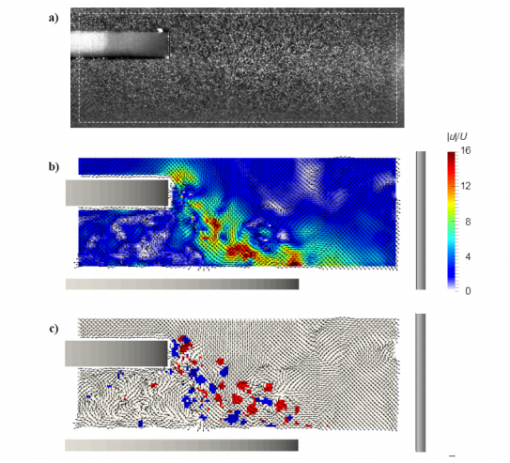
圖2 ?a)典型的后處理瞬時粒子圖像,b)從圖2a獲得的瞬時速度分布����,和c)從圖2b獲得的速度梯度張量(Q)的第二不變量的正區(qū)域。圖2a中的虛線矩形顯示了進行PIV計算的區(qū)域��。在圖2b中��,彩色輪廓表示由U歸一化的速度的大小����,箭頭表示速度的方向。在圖2c中����,紅色和藍色區(qū)域分別是觀察到逆時針漩渦和順時針漩渦的地方。
渦區(qū)域的三維結(jié)構:圖3表示的是用LES得到的結(jié)果��。圖中表示的是U=0.04m/s, q = 20.9 rad/s (相當于q = 0.5m/min, n=200rpm )時0= 200的等值面���。根據(jù)圖,在該條件下旋轉(zhuǎn)����,可以看出向筒壁延伸。這個渦流管從圓盤的旋轉(zhuǎn)方向看是順時針旋轉(zhuǎn)的�。而且這個渦流管穩(wěn)定地存在于流場中,以比圓板的旋轉(zhuǎn)角速度慢得多的角速度在與圓板相同的方向上旋轉(zhuǎn)�。
這樣,通過本研究得知�����,在以清洗機內(nèi)流動為代表的旋轉(zhuǎn)圓板�、包圍旋轉(zhuǎn)圓板的外筒以及主流的流動中����,從圓板端朝向容器外筒的大規(guī)模旋轉(zhuǎn)渦流形成穩(wěn)定的模式����。這樣的渦旋結(jié)構引起了粒子的大規(guī)模再循環(huán),另外�����,即使在下降流占主導地位的大規(guī)模螺旋渦的尾流中�,如圖4a、4d�、4h所示,在圓板端產(chǎn)生的小規(guī)模旋渦會停留在圓板端附近�����,因此會引起在晶片外周附近的污染物的再附著對于清洗機來說����,這種穩(wěn)定的大規(guī)模結(jié)構是不可取的,今后破壞這種縱向渦流結(jié)構可能會提高裝置的性能����,這種穩(wěn)定的渦流結(jié)構在靜止的殼體中旋轉(zhuǎn)圓盤的情況下和在兩個旋轉(zhuǎn)圓板內(nèi)夾著的流體中形成的渦流結(jié)構類似。
?
總結(jié)
在本研究中����,我們進行了單張式硅片清洗裝置內(nèi)的二維瞬態(tài)PIV測量和三維LES���,并在清洗機內(nèi)形成進行了三維渦流結(jié)構的推定��。另外�����,PIV測量����、LES在渦結(jié)構的鑒定中都是速度梯度張量使用的第2不變量Q2值����,根據(jù)PIV測量的結(jié)果可知����,通過圓板的旋轉(zhuǎn)從其端面形成多個渦流,存在從圓板端朝向排氣罩的帶狀渦流區(qū)域��,該渦流區(qū)域中����,來自裝置上方的下降流占優(yōu)勢被壓入圓板和排氣罩之間的情況、以及圓板和排氣罩之間的流動的放射流分為兩部分��,它們周期性的重復��。這種現(xiàn)象的頻率與圓板的轉(zhuǎn)速成比例地增加,這個趨勢與實驗中觀測到的����、渦的存在區(qū)域與圓板的轉(zhuǎn)速成比例周期性變化的其頻率的增加趨勢一致,可以得出結(jié)論�,在實驗中也存在著通過LES得到的大規(guī)模結(jié)構。