
掃碼添加微信,獲取更多半導(dǎo)體相關(guān)資料
引言
隨著半導(dǎo)體器件不斷向越來(lái)越小的尺寸發(fā)展��,保持硅表面無(wú)污染以提高器件功能�����、產(chǎn)量和可靠性變得越來(lái)越重要����。基于RCA的濕法化學(xué)清洗仍然廣泛用于半導(dǎo)體器件制造工藝���。經(jīng)過(guò)SC-1和SC-2處理后��,硅表面具有約1納米厚的化學(xué)氧化層���。對(duì)于預(yù)浸清洗,低質(zhì)量的化學(xué)氧化層最好在生長(zhǎng)高質(zhì)量的熱柵氧化層之前去除����。這可以通過(guò)稀氟化氫(DHF)處理來(lái)實(shí)現(xiàn)����。
在本方法中���,我們結(jié)合電位測(cè)量技術(shù)��、TXRF技術(shù)和電感耦合等離子體質(zhì)譜法來(lái)測(cè)定不同添加劑在DHF溶液中對(duì)硅表面超壓銅輸出的影響���。用光散射和透射電鏡研究了溶液中表面活性劑與銅離子的相互作用。用掃描電鏡研究了表面活性劑對(duì)減少硅表面銅成核的影響����。硅表面吸附的表面活性劑層用原子力顯微鏡進(jìn)行了驗(yàn)證。在此基礎(chǔ)上�,總結(jié)了DHF清潔生產(chǎn)中對(duì)銅產(chǎn)出的表面影響�。
?
實(shí)驗(yàn)
我們選用鹽酸����、雙氧水、硝酸、陽(yáng)離子表面活性劑和陰離子表面活性劑等不同添加劑�����,研究它們對(duì)銅輸出的影響�。我們使用的陽(yáng)離子表面活性劑是烷基四甲基溴化銨(CTAB)��,陰離子表面活性劑是含硫表面活性劑�。它們具有相似的鏈結(jié)構(gòu)和分子量�����。我們之前的結(jié)果表明����,這兩種方法在稀釋過(guò)程中都有效地防止了顆粒的再沉積。用一個(gè)2英寸(100)電阻率為1-10ωcm的n型硅片(Silicon Quest International)在安裝到定制的特氟隆電化學(xué)電池之前�,經(jīng)過(guò)SC-1清洗����、DHF清洗和去離子水沖洗����,以去除顆粒和化學(xué)氧化物����。只有晶片的拋光面與溶液接觸,背面與不銹鋼基底接觸��,不銹鋼基底與外部有不銹鋼連接�����。在晶片背面和金屬基底之間使用了共晶鎵銦合金薄膜,以確保歐姆接觸���。在電池中使用50毫升0.5重量%的含/不含添加劑的溶液���。使用25 W徠卡白熾燈,光線直射到晶片上�。
為了再生硅,采用5 mL 5%氫氟酸+ 5%硝酸+ 5%過(guò)氧化氫溶液去除表面銅��。表面污染由TXRF和飛行時(shí)間二次離子質(zhì)譜(TOF-SIMS)檢測(cè)�����。將硅片樣品浸入含/的0.5% HF + 100 ppb銅浴中���。在光照下無(wú)表面活性劑10分鐘���。在所有的實(shí)驗(yàn)中���,表面活性劑濃度為1%(重量)���。通過(guò)動(dòng)態(tài)光散射在1%陰離子表面活性劑+500 ppm銅/污染物水溶液中進(jìn)行粒度分析����。還對(duì)1%陰離子表面活性劑+500 ppm銅污染物中的顆粒進(jìn)行了透射電鏡分析��。透射電鏡樣品是通過(guò)將覆蓋有無(wú)定形碳薄膜的銅網(wǎng)格浸入溶液中以捕獲顆粒而制備的。硅表面上吸附的表面活性劑層的表征是通過(guò)使用具有原子力顯微鏡的表面力測(cè)量技術(shù)來(lái)完成的。液體電池和氮化硅尖端都來(lái)自數(shù)字儀器��。
? ? ? ?還研究了表面活性劑對(duì)保護(hù)受損硅表面免受銅輸出的影響。表面損傷可能是由用劃痕儀刮傷硅表面引起的��。將面積為1 × 1 cm的劃開的晶片片浸入含和不含表面活性劑的0.5% HF + 1 ppm Cu2+溶液中���,在25 W白熾燈下照明10分鐘。然后是晶片片用去離子水沖洗并進(jìn)行掃描電鏡觀察�。拍攝了二次電子圖像和特征銅和硅的Kα X光圖像�。
?
結(jié)果和討論
? ? ? 表征銅輸出添加劑效率的電位法。—DHF溶液中的銅離子導(dǎo)致硅電極和參比電極之間的OCP變化����。圖1中繪制了添加銅的硅電極的OCP變化。OCP變化與整體銅濃度密切相關(guān)��。每次加入銅后����,OCP值突然增加�,然后在15分鐘后逐漸變?yōu)橄鄬?duì)穩(wěn)定的值。隨著更多銅污染物的加入���,觀察到OCP值的類似變化�����。在水沖洗后��,在同一電極上使用沒有銅污染的新鮮0.5% HF溶液,OCP沒有回到其原始值���,因此表明OCP響應(yīng)不是由銅引起的。圖2中繪制的結(jié)果進(jìn)一步驗(yàn)證了這種說(shuō)法���,其中使用反萃溶液溶解表面銅�,新鮮0.5% HF中的OCP回到大約原始值��。這證實(shí)了表面銅���,而不是溶液中的銅�����,是造成OCP變化的原因���。
?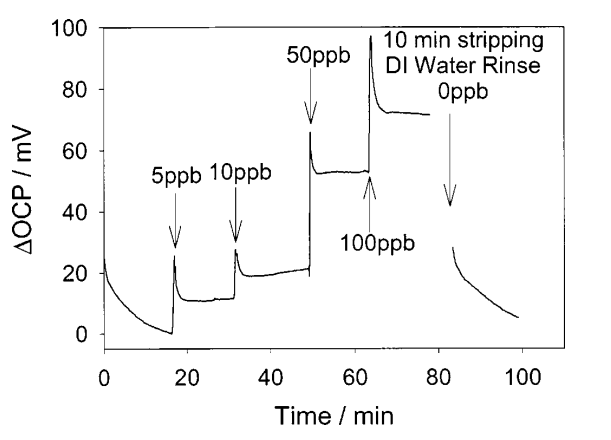
圖2 隨著銅的加入,OCP變化
? ? ? 圖3繪制了OCP變化與大塊銅濃度對(duì)數(shù)的函數(shù)關(guān)系�。最小二乘回歸結(jié)果表明,OCP變化與對(duì)數(shù)[Cu/ppb]呈線性關(guān)系r2 = 0.99���。圖4總結(jié)了同一批次的不同p型晶片上的OCP變化與時(shí)間的關(guān)系��,圖5顯示了從同一批次的不同n型晶片獲得的相同參數(shù)。這表明n型晶片比p型晶片具有更高的斜率����。Norga等人報(bào)告說(shuō)����,n型晶片比p型晶片更易受銅輸出的影響����。14因此���,斜率變化與銅輸出的易感性定性相關(guān)。從圖4和圖5中�����,我們可以看到回歸線的斜率比絕對(duì)OCP值更具可重復(fù)性�。這是因?yàn)楣桦姌O的OCP也取決于其表面條件���。很難在不同的晶片上或同一晶片上在不同的時(shí)間有相同的表面條件(在附錄中討論了硅電極在DHF溶液中的OCP變化機(jī)理)����。然而�����,回歸線的可重復(fù)斜率可以提供銅輸出程度的定性測(cè)量,從而提供添加劑的效率�����。
?
圖5 ?n型晶片OCP變化與銅塊濃度對(duì)數(shù)的關(guān)系
? ? ? DHF清洗過(guò)程中表面活性劑對(duì)銅輸出的影響綜述�����。根據(jù)所呈現(xiàn)的結(jié)果和先前公布的結(jié)果���,表面活性劑在DHF清洗期間銅污染中的作用可總結(jié)如下:
表面活性劑在硅表面形成保護(hù)層。硅上吸附的表面活性劑分子層阻礙硅表面和銅離子之間的電子轉(zhuǎn)移���。因?yàn)楣璞砻嫔系你~還原不再受擴(kuò)散控制(圖9)����,推斷限速步驟是電子轉(zhuǎn)移�。對(duì)缺乏優(yōu)先成核的直接觀察(圖15)也支持這一結(jié)論�。硅表面表面活性劑層形成的證據(jù)是ζ-電位變化3和直接測(cè)力的結(jié)果。
? ? ? 表面活性劑與銅離子相互作用���。表面活性劑���,尤其是陰離子表面活性劑,可能與銅離子有很強(qiáng)的相互作用�����。我們的光散射實(shí)驗(yàn)結(jié)果可以作為證據(jù)(圖10)。表面活性劑對(duì)銅的輸出有兩種影響�����。一是表面活性劑降低了自由銅離子的濃度����,導(dǎo)致銅輸出的驅(qū)動(dòng)力降低(圖8)。另一種是表面活性劑-銅離子絡(luò)合物可能吸附在硅表面���。如果這種復(fù)合物不能通過(guò)去離子水沖洗完全沖洗����,那么銅污染會(huì)增加(圖12)。
? ? ? 表面活性劑在銅輸出中的作用不是孤立的�����。因此�����,我們觀察到表面活性劑對(duì)鍍銅的不同影響��。吸附污染機(jī)理表明���,如果表面活性劑被用于DHF清潔���,這被提議最小化顆粒再沉積�����,那么研究其對(duì)金屬污染以及具有低還原電位的其他金屬的影響是至關(guān)重要的�。
?
總結(jié)
? ? ? 我們研究了DHF清洗過(guò)程中添加劑對(duì)銅在硅表面輸出的影響����。我們通過(guò)不同的實(shí)踐證明��,在DHF清洗過(guò)程中�,鹽酸、過(guò)氧化氫和硝酸等添加劑能有效降低銅的輸出����。我們指出了十六烷基三甲基溴化銨能有效減少銅的輸出�����。DHF清洗期間的硅表面�����。陰離子表面活性劑通過(guò)與金屬離子形成絡(luò)合物并隨后吸附在硅表面上,可以增加金屬輸出�,不僅是銅����,還有其他金屬,如鎳��。結(jié)合OCP監(jiān)測(cè)�、表面金屬分析和顯微鏡研究����,可以區(qū)分銅輸出的不同機(jī)理��。實(shí)驗(yàn)數(shù)據(jù)表明(1)硅表面上吸附的表面活性劑層可以阻礙硅表面和銅離子之間的電子轉(zhuǎn)移����,(2)本體溶液中的表面活性劑分子可以與金屬相互作用�����。既可以降低金屬外層驅(qū)動(dòng)力,也可以增加金屬離子-表面活性劑配合物的物理吸附趨勢(shì)����。