
掃碼添加微信���,獲取更多半導(dǎo)體相關(guān)資料
近年來(lái)����,作為取代SPM(硫酸/過(guò)氧化氫)清洗的有機(jī)物去除法��,通過(guò)添加臭氧的超純水進(jìn)行的清洗受到關(guān)注����,其有效性逐漸被發(fā)現(xiàn)���。在該清洗法中,可以實(shí)現(xiàn)清洗工序的低溫化、操作性的提高����、廢液處理的不必要化�、封閉系統(tǒng)的實(shí)現(xiàn)��。另一方面��,動(dòng)態(tài)自旋清洗法解決了現(xiàn)在普遍使用的靜態(tài)分批清洗法中存在的交叉污染���、藥液使用量的減少化���、清洗時(shí)間的縮短化問(wèn)題�,而且還可以抑制自然氧化膜的生成�����,因此受到了人們的關(guān)注����。將自旋清洗法與添加臭氧的超純水相結(jié)合的新清洗法�,與以往的方法相比���,具有更好的清洗能力�����,在抑制自然氧化膜生成的同時(shí)�,可以在短時(shí)間內(nèi)完全除去晶片表面的有機(jī)物。
有機(jī)物的影響和除去方法有機(jī)物污染是必須從晶片表面除去的污染物之一���。作為污染源,被認(rèn)為是涉及潔凈室內(nèi)的空氣��、晶片載體�����、晶片盒���、藥品�、清洗工具等多種多樣的污染源。物理吸附在晶片表面的有機(jī)物分子以粒子或薄膜狀復(fù)蓋表面�����,為了遮擋與清洗藥液的接觸�,清洗效率(金屬�����、粒子除去)降低���,表面的不均勻蝕刻,以及外延硅層的生長(zhǎng)、柵極氧化膜的擊穿�����,因此,一般認(rèn)為晶片表面上的有機(jī)物除去在清洗工序中必須首先在完全壁上進(jìn)行��。
有機(jī)物去除機(jī)理根據(jù)利用FT-ⅠR的觀察��,已經(jīng)推測(cè)有機(jī)物具有島狀或至少不均勻的厚度,是物理吸附的�。有機(jī)物的除去使用的是利用氧化分解的清洗法,但是由于清洗后的晶片表面會(huì)形成氧化硅膜�����,所以一般組合進(jìn)行用于除去氧化膜的清洗(稀氫氟酸清洗等)�。SPM清洗��、添加臭氧的超純水清洗基本上都需要完全分解有機(jī)物����,是理想的���,但是認(rèn)為有些有機(jī)物在數(shù)10分鐘的清洗時(shí)間內(nèi)大多不能分解�����。據(jù)推測(cè)��,在這種情況下,本來(lái)為了除去氧化膜而進(jìn)行的清洗會(huì)對(duì)有機(jī)物的除去提供幫助����。通過(guò)這一連串的清洗去除有機(jī)物的機(jī)理可考慮如下�。圖3模式化地表示了去除機(jī)理����。
?
圖3 有機(jī)物去除機(jī)理圖
被有機(jī)物污染的晶圓浸漬在清洗液(硫酸/過(guò)氧化氫���、添加臭氧的超純水)中后�,氧化反應(yīng),即有機(jī)物的氧化分解或者沒(méi)有吸附有機(jī)物的部分開(kāi)始硅的氧化�。 如果進(jìn)一步進(jìn)行氧化反應(yīng)�����,在晶片表面整體上形成氧化硅膜,未被分解而殘留的難分解有機(jī)物成為騎在氧化膜上的形式��。 因此���,即使不完全分解有機(jī)物���,只要在該時(shí)刻進(jìn)行除去氧化膜的操作��,就可以從晶片表面除去有機(jī)物��。 但是���,如果氧化膜的形成在面內(nèi)不均勻���,則清洗后的晶圓表面為了增加表面的粗糙度���,需要設(shè)定適當(dāng)?shù)难趸瘯r(shí)間�����。
新的清洗方法:靜態(tài)洗滌方法:圖4顯示的是只進(jìn)行了預(yù)清洗的晶片的光譜( Pre-cleaned )和在能夠被認(rèn)為有機(jī)物完全熱分解的1000°C下進(jìn)行熱氧化處理的晶片的光譜( Thermal oxidation )。 后者沒(méi)有檢測(cè)出表示有機(jī)物存在的峰值,但前者可以明確確認(rèn)����。另外���,添加臭氧的超純水清洗��、SPM清洗的情況下,這種傾向也得到了同樣的結(jié)果��,表明了一直以來(lái)使用的靜態(tài)清洗法的清洗能力是有限的�����。
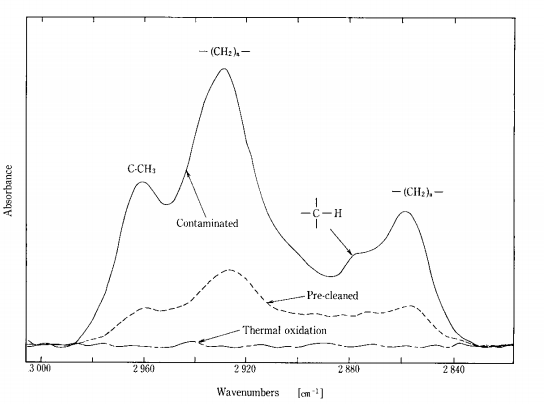 ?
?
圖4 批量清洗法的能力極限
動(dòng)態(tài)洗滌方法:在裝置中��,將晶片安裝在清洗室內(nèi)的卡盤(pán)上,在高速旋轉(zhuǎn)的同時(shí)��,通過(guò)可動(dòng)式噴嘴供給清洗藥液或超純水�����。罩上部有高純度氮的導(dǎo)入口�����,通過(guò)經(jīng)常吹掃��,可以防止?jié)崈羰抑械目諝馕廴尽A硗?�,可以抑制自然氧化膜的生成�����。此外��,該裝置不僅可以除去有機(jī)物����,還可以在一個(gè)清洗室內(nèi)進(jìn)行包括金屬雜質(zhì)��、粒子/粒子除去清洗在內(nèi)的所有清洗工序�����。在該方法中����,具有經(jīng)常向晶圓表面供給新鮮的藥液�,通過(guò)旋轉(zhuǎn)產(chǎn)生的遠(yuǎn)Jb力形成均勻的流動(dòng)�����,在R舜時(shí)從晶圓表面除去不需要的反應(yīng)生成物的優(yōu)良特點(diǎn)��。
自旋清洗法:旋轉(zhuǎn)清洗法���、分批清洗法均為5分鐘(分批清洗為10分鐘)的10ppm臭氧添加超純水��,對(duì)被有機(jī)物污染的晶片分別進(jìn)行清洗、超純水清洗�����、稀氫氟酸清洗和最終超純水清洗��。
在旋轉(zhuǎn)清洗法中��,去除率隨著旋轉(zhuǎn)次數(shù)的增加而提高,在1500rpm左右時(shí)����,與分批清洗法相比�,只能得到較低的去除率�����,但在旋轉(zhuǎn)3000rpm以上時(shí)��,可以去除到完全檢測(cè)不出有機(jī)物的峰值的程度�。此外,該清洗方法同時(shí)可以完全抑制Si-OH����、Si-0-Si的生成。此外���,由于在這種裝置中��,按照預(yù)先設(shè)定的工序順序����,在完全控制的條件下進(jìn)行清洗,因此可以認(rèn)為是一種均勻性�、再現(xiàn)性優(yōu)異的清洗方法�����。
我們能夠檢測(cè)出晶片表面極微量存在的有機(jī)物���,而且通過(guò)動(dòng)態(tài)清洗法能夠提供以往方法無(wú)法得到的高清潔度的晶片表面�,這成為了解明至今尚不清楚的有機(jī)物影響的切入點(diǎn),尤其包括器件的高性能化����、微細(xì)加工技術(shù)的進(jìn)步���。