
掃碼添加微信���,獲取更多半導體相關資料
本文介紹了新興的全化學晶片清洗技術,研究它們提供更低的水和化學消耗的能力����,提供了每種技術的工藝應用����、清潔機制�、工藝效益和考慮因素����、環(huán)境、安全和健康(ESH)效益和考慮因素����、技術狀態(tài)和供應商信息的可用信息�。
將晶片暴露于少量(約1克)無水三氧化硫氣體中,然后自動轉移到一個單獨的室中�����,在那里用去離子水沖洗并甩干(見圖1)���,三氧化硫室的條件要求溫度通常低于100°C,且環(huán)境干燥�����,光致抗蝕劑在暴露于三氧化硫期間沒有被去除���,而是被化學改性,一旦磺化�����,抗蝕劑可溶于水���,并在去離子水沖洗過程中被去除�����,該工具目前是單晶片單元�����,但可以擴展到批處理工具配置。
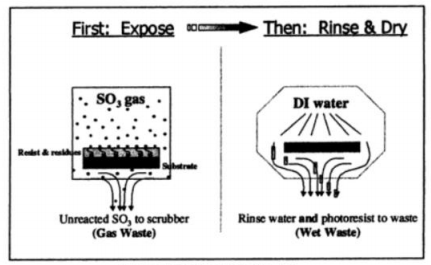 ?
?
圖1
三氧化硫技術將兩個清洗步驟/工具合二為一����,取代了灰化器和用于灰化后殘留物清洗的濕工作臺����,一種工具的好處包括在大多數(shù)剝離應用中完全消除了等離子體��,剝離離子注入光刻膠后減少了污染�,減少了占地面積��,降低了維護��,減少了周期時間�,并降低了成本����。工藝開發(fā)的重點是可以集成到集群工具中的單晶片旋轉處理器�,晶片被安裝在晶片旋轉器的卡盤上��,并被加速到預定的轉速(1000到4000轉/分),蝕刻化學物質被分配到旋轉晶片的表面上大約1-3分鐘,工藝溫度為45至55℃,過程pH值接近中性,所以旋轉蝕刻循環(huán)之后是短暫的去離子水旋轉沖洗和旋干循環(huán)���。
在下午0點35分和0點18分為150毫米晶圓準備了150毫米晶圓的氧化后蝕刻和金屬蝕刻后測試結構,一組四個測試結構是在臭氧水清洗過程之前的氧等離子體棚��,清潔前沒有按壓其他器械包���,用HP 拍攝的截面掃描電子顯微鏡(SEM)照片提供了對新工藝清潔和腐蝕性能的初步評估��,根據(jù)電子顯微鏡檢查�����,在某種測試結構中沒有金屬腐蝕的跡象����,過程溫度低���,接近中性酸鹽,金屬腐蝕可能性降低���。
本文通過回顧新清洗的挑戰(zhàn)和工藝標準,并對一些新興的清洗技術進行了評述����,必須找到具有成本效益的清潔技術���,快速、安全�����、徹底地清除所有污染物��,不會對金屬、低k或高k材料造成損壞�,并且會使用更少的水和化學物質。