
掃碼添加微信,獲取更多半導(dǎo)體相關(guān)資料
摘要
在濕法體微機(jī)械加工中�,蝕刻特性取決于取向。Si{100}和Si{110}晶片上任何幾何形狀的掩模開口的延長蝕刻導(dǎo)致由最慢蝕刻平面限定的結(jié)構(gòu)����。為了制造高尺寸精度的微結(jié)構(gòu),對準(zhǔn)沿著晶體方向的掩模邊緣包括這些最慢的蝕刻平面���。因此�,掩模邊緣的精確對準(zhǔn)在微/納米制造中很重要����。因此,確定精確的晶體方向至關(guān)重要�����,事實上��,這是確保微結(jié)構(gòu)尺寸精確以提高性能的第一步�����。在這篇綜述文章中����,我們對精確確定晶體學(xué)方向的不同技術(shù)進(jìn)行了綜合分析。我們已經(jīng)介紹了在二十多年的時間里提出的確定Si{100}和Si{110}晶片上的結(jié)晶方向的各種技術(shù)�����。除了詳細(xì)討論每種技術(shù)及其設(shè)計和實現(xiàn)之外�����,我們還對相關(guān)的限制�����、優(yōu)點和缺點進(jìn)行了批判性分析����。我們還總結(jié)了每種技術(shù)的關(guān)鍵方面,并以表格的形式呈現(xiàn)��,以方便讀者參考。這篇綜述文章由詳盡的討論組成���,對于在濕法各向異性蝕刻領(lǐng)域中的新手或想了解晶體方向測定技術(shù)的研究人員來說是一個方便的參考����。
?
介紹
微機(jī)械加工是MEMS/NEMS工業(yè)中微/納米制造的一個組成部分�����。有兩種微加工方法��,即表面微加工和體微加工�����。顧名思義��,表面微加工技術(shù)利用襯底(例如晶片)的表面��,并且使用表面上沉積的薄膜來制造微/納米結(jié)構(gòu)���。沉積的薄膜用作結(jié)構(gòu)層和犧牲層�。另一方面,體微加工選擇性地蝕刻體以制造三維特征����、懸梁����、薄膜等。體微加工進(jìn)一步分為兩類:干法和濕法蝕刻��。干法蝕刻主要使用氣相等離子體進(jìn)行�����,但聚焦離子束和激光加工也用于某些特殊情況�����。如果使用濕化學(xué)藥品進(jìn)行蝕刻����,則稱為濕蝕刻?;诓煌较虻奈g刻速率,濕法蝕刻可以進(jìn)一步細(xì)分為各向同性和各向異性蝕刻����。在各向同性蝕刻中����,蝕刻速率在所有方向上都是相同的�,并且不取決于結(jié)晶方向,然而在各向異性蝕刻的情況下��,蝕刻速率是結(jié)晶取向的函數(shù)���。普通硅濕各向同性蝕刻劑是HF��、HNO3和CH3COOH的混合物����,而氫氧化鉀(KOH)和四甲基氫氧化銨蝕刻劑最廣泛地用于濕法各向異性蝕刻��。還有一些其它的堿性溶液已經(jīng)被研究用于硅濕法各向異性蝕刻�,例如乙二胺鄰苯二酚水(EDP或EPW)氫氧化銨,和氫氧化銫(CsOH)����。在濕法各向異性蝕刻中,面是所有類型的各向異性蝕刻劑中蝕刻速率最慢的面�����。因此,硅晶片中穩(wěn)定的蝕刻輪廓(或延長的蝕刻輪廓)由{111}面形成��,例如�,Si{100}晶片上的任意形狀的掩模開口導(dǎo)致在四個相互垂直的方向上由面組成的正方形/矩形v形槽�����,如圖2所示�����。1 而在Si{110}晶片上���,它給出六邊形溝槽型結(jié)構(gòu)�,包括在?110?和?112?方向上的{111}面����。
?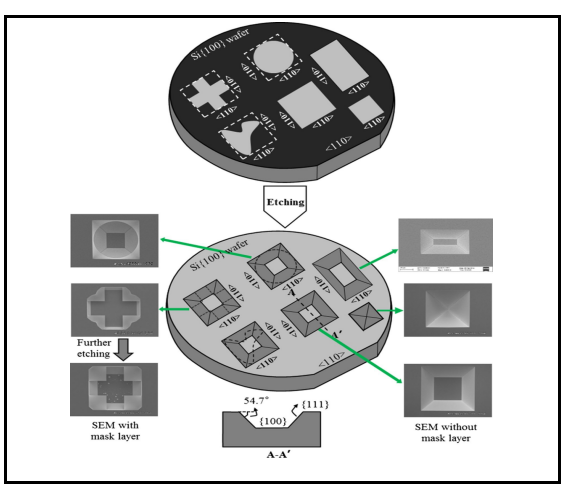
圖?2
?
預(yù)蝕刻圖案
解理邊緣方法依賴于晶片平面的精度以及處理器沿劃線解理(或切割)晶片的精度。此外����,它還取決于劃線方向的準(zhǔn)確性。因此,這不是確保精確確定結(jié)晶方向的最佳方法�����。因此�,需要更精確的技術(shù)來精確確定晶體方向。過去����,研究人員已經(jīng)使用各向異性蝕刻來制作圖案,以高精度確定結(jié)晶方向(例如���,?110?��、?100?)�����。這些圖案被蝕刻在晶片的外圍��,因此可用的晶片空間不會受到顯著影響�。這些預(yù)蝕刻的圖案有助于隨后對準(zhǔn)掩模邊緣��。這種對準(zhǔn)方法在精確確定結(jié)晶方向方面是精確的��,精確度高達(dá)0.01°。這有助于研究人員為不同的應(yīng)用制造尺寸精確的微結(jié)構(gòu)�����。以前已經(jīng)提出了許多關(guān)于對準(zhǔn)技術(shù)及其精度的設(shè)計����。
?
結(jié)論
這篇綜述文章旨在將迄今為止提出的精確確定Si{100}和Si{110}晶片結(jié)晶方向的不同技術(shù)集中在一個地方。討論了不同的技術(shù)���,包括解理邊緣法和使用預(yù)蝕刻圖案來確定晶體方向。根據(jù)不同幾何圖形在Si{100}或Si{110}晶片上的適用性���,對它們進(jìn)行了分析�。沿著晶體方向?qū)?zhǔn)掩模邊緣的基本技術(shù)是使用晶片平面作為參考���。然而����,考慮到確定晶片平面的不確定性����,當(dāng)需要高尺寸精度時����,這是不夠的�。

因此,開發(fā)了替代方法��。其中之一是通過使用晶片平面作為參考制造結(jié)構(gòu)����,然后使用具有最小底切長度的結(jié)構(gòu)邊緣作為精確的晶體方向。然而�,測量這種在某些情況下非常小的底切長度是一項繁瑣的任務(wù),并且需要復(fù)雜的設(shè)備���。為了克服這些缺點����,已經(jīng)提出了不需要任何測量的其他技術(shù)�����。一種是通過選擇在蝕刻后拐角合并的結(jié)構(gòu)����,另一種是通過選擇具有對稱底切的結(jié)構(gòu)等����。雖然這些技術(shù)不需要測量����,但是由于晶片上不同位置的底切率不同,難以確定底切對稱的目標(biāo)結(jié)構(gòu)等�,仍然會帶來相關(guān)的誤差。最近���,已經(jīng)開發(fā)了自對準(zhǔn)技術(shù)�����,由于結(jié)構(gòu)的自對準(zhǔn)性質(zhì),該技術(shù)使得晶體方向看起來很明顯�。這些技術(shù)在無需測量、魯棒性���、實現(xiàn)簡單以及減少識別方向所需的努力方面克服了所有先前技術(shù)的缺點���。這些技術(shù)可以在不使用任何復(fù)雜設(shè)備的情況下使用。